有価証券報告書-第57期(平成26年4月1日-平成27年3月31日)
事業内容
当社グループ(当社および当社の関係会社)は、当社および子会社11社により構成されており、半導体メーカーおよび電子部品メーカー向け半導体製造装置の開発・製造・販売を主たる事業とし、さらに、当該事業に関連する保守サービスを展開しています。
なお、当社グループは、単一業種の事業活動を展開し、経営資源の配分の意思決定を事業全体で実施していることから、セグメントは単一であり、セグメント情報を記載していません。
提出会社
半導体製造装置のうちワイヤボンダ、ダイボンダ、フリップチップボンダ等ボンディング装置の開発・製造・販売を行っており、また、これらの装置の据付調整、修理、保守サービスを行っています。
半導体の製造工程は、大きく前工程と後工程とに分けられます。スライスされた円盤状のシリコンウェーハ上に写真の感光の原理を用いて、トランジスタや金属配線などの回路を形成するまでが前工程と呼ばれています。
さらに、そのシリコンウェーハからICチップを切り出し、チップをパッケージに固定、配線し、セラミックや樹脂の中に封入することにより半導体製品に組み立てるまでが後工程と呼ばれています。
当社の製品は、後工程の中でもICチップを固定、配線するボンディングと呼ばれる工程に使用される産業用精密ロボットです。
○半導体製造工程

○ボンディング装置の機能
ダイボンダは、薄さ数十ミクロン(1ミクロンは1/1000ミリ)、幅数ミリ角のICチップをリードフレーム(※1)等のパッケージの所定位置に接着固定する機能を持つ装置です。
また、ワイヤボンダはダイボンダで接着されたICチップの端子とパッケージ側の端子を導通させるために、十数ミクロン径の金または銅のワイヤを用いて高速、高精度で配線する装置です。ワイヤの配線には超音波と熱圧着の技術を用いています。
ダイボンダおよびワイヤボンダは、メモリIC、汎用LSIに代表される多くの半導体の製造工程において使用されています。それぞれを図示すると、次のとおりです。
※1 リードフレームはICチップを接着する台となる薄板状の金属であり、パッケージを外部回路と繋ぐ橋渡しの役目も果たしています。
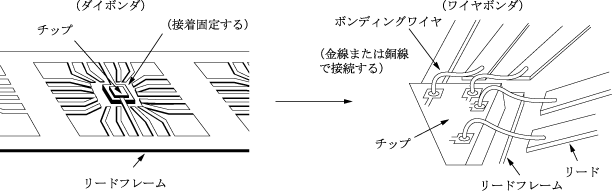
フリップチップボンダは、ワイヤを用いず半田ボール等(※2) の金属を介して、ICチップを樹脂基板等に接合するボンディング装置です。接合には熱圧着または超音波熱圧着の技術を用いています。主に高性能CPUや無線デバイスなどの製造工程において使用されます。
※2 数十ミクロン程度の半田の小さなボールまたは柱状に形成された銅などで、ICチップの電極と基板等の電極を接合する役目を果たします。
○製品納入までの主な工程
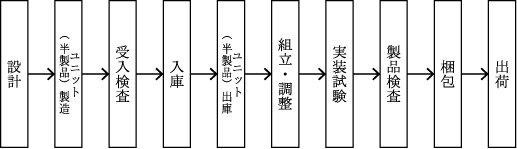
(注) 上記の工程で、ユニット(半製品)製造は、社外のサプライヤで行っています。
関係会社
(販売・保守サービス他)
新川韓国株式会社、新川半導体機械股份有限公司、新川 (上海) 半導体機械有限公司、Shinkawa Philippines, Inc.、Shinkawa Singapore Pte. Ltd.、Shinkawa (Malaysia) Sdn. Bhd.、Shinkawa (Thailand) Co., Ltd.、Shinkawa U.S.A., Inc.
(ソフトウエア開発)
Shinkawa Vietnam Co., Ltd.
(開発・製造・販売)
株式会社新川テクノロジーズ、Shinkawa Manufacturing Asia Co., Ltd.
事業系統図
以上述べた事項を事業系統図によって示すと次のとおりです。

なお、当社グループは、単一業種の事業活動を展開し、経営資源の配分の意思決定を事業全体で実施していることから、セグメントは単一であり、セグメント情報を記載していません。
提出会社
半導体製造装置のうちワイヤボンダ、ダイボンダ、フリップチップボンダ等ボンディング装置の開発・製造・販売を行っており、また、これらの装置の据付調整、修理、保守サービスを行っています。
半導体の製造工程は、大きく前工程と後工程とに分けられます。スライスされた円盤状のシリコンウェーハ上に写真の感光の原理を用いて、トランジスタや金属配線などの回路を形成するまでが前工程と呼ばれています。
さらに、そのシリコンウェーハからICチップを切り出し、チップをパッケージに固定、配線し、セラミックや樹脂の中に封入することにより半導体製品に組み立てるまでが後工程と呼ばれています。
当社の製品は、後工程の中でもICチップを固定、配線するボンディングと呼ばれる工程に使用される産業用精密ロボットです。
○半導体製造工程

○ボンディング装置の機能
ダイボンダは、薄さ数十ミクロン(1ミクロンは1/1000ミリ)、幅数ミリ角のICチップをリードフレーム(※1)等のパッケージの所定位置に接着固定する機能を持つ装置です。
また、ワイヤボンダはダイボンダで接着されたICチップの端子とパッケージ側の端子を導通させるために、十数ミクロン径の金または銅のワイヤを用いて高速、高精度で配線する装置です。ワイヤの配線には超音波と熱圧着の技術を用いています。
ダイボンダおよびワイヤボンダは、メモリIC、汎用LSIに代表される多くの半導体の製造工程において使用されています。それぞれを図示すると、次のとおりです。
※1 リードフレームはICチップを接着する台となる薄板状の金属であり、パッケージを外部回路と繋ぐ橋渡しの役目も果たしています。
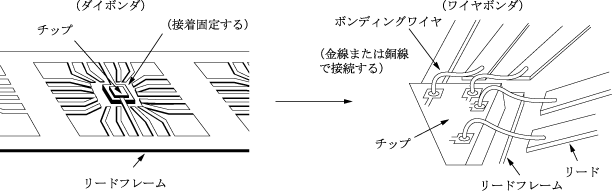
フリップチップボンダは、ワイヤを用いず半田ボール等(※2) の金属を介して、ICチップを樹脂基板等に接合するボンディング装置です。接合には熱圧着または超音波熱圧着の技術を用いています。主に高性能CPUや無線デバイスなどの製造工程において使用されます。
※2 数十ミクロン程度の半田の小さなボールまたは柱状に形成された銅などで、ICチップの電極と基板等の電極を接合する役目を果たします。
○製品納入までの主な工程
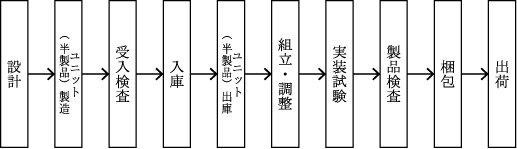
(注) 上記の工程で、ユニット(半製品)製造は、社外のサプライヤで行っています。
関係会社
(販売・保守サービス他)
新川韓国株式会社、新川半導体機械股份有限公司、新川 (上海) 半導体機械有限公司、Shinkawa Philippines, Inc.、Shinkawa Singapore Pte. Ltd.、Shinkawa (Malaysia) Sdn. Bhd.、Shinkawa (Thailand) Co., Ltd.、Shinkawa U.S.A., Inc.
(ソフトウエア開発)
Shinkawa Vietnam Co., Ltd.
(開発・製造・販売)
株式会社新川テクノロジーズ、Shinkawa Manufacturing Asia Co., Ltd.
事業系統図
以上述べた事項を事業系統図によって示すと次のとおりです。
